Это 1-я статья из цикла.
2-я статья - Mapper — наш, или еще одна технология электронно-много-лучевой литографии
3-я статья - KLA-Tencor — революция в много-лучевой электронной литографии
Для начала о проблеме
Из каждого «утюга» мы слышим о нанометрах в микроэлектронике. Те, кто чуть глубже погружен в тему слышали о том, что для получения заветных нанометров используют литографы и что самые продвинутые производители микросхем переходят с литографов на DUV (Deep Ultra-Violet, Глубокий ультрафиолет с длиной волны 193 нм) на EUV (Extreme Ultra-Violet, Экстремальный ультрафиолет с длиной волны 13,5 нм).
Но чтобы получить рисунок на пластине, нужно сначала получить его на фотошаблоне. Причем рисунок на фотошаблоне зачастую бывает намного сложнее, чем получаемый в итоге отпечаток на кремниевой пластине. Это делается для подавления эффекта «близости» и подавления эффектов возникающих из-за дифракции.

Хотя размер рисунка фотошаблона обычно в 4 раза больше итогового рисунка на пластине, точность его изготовления должна быть не хуже точности рисунка на пластине, т.к. все «рваные» края и «округлые» углы на фотошаблоне будут усилены на пластине более чем в 4 раза.
До некоторого предела, а точнее, для фотошаблонов на техпроцесс до 180 нм используют лазерные генераторы фотошаблонов. Но для техпроцессов от 180 нм и меньше уже невозможно, используя лазерный луч, добиться точности, необходимой для фотошаблонов. И здесь начинается использование электронно-лучевых литографов. Т.к. длина волны у электрона на несколько порядков меньше длины ультрафиолетового излучения, то появляется возможность рисовать лучом из электронов структуры с точностью до 1-5 нм.
Но… как всегда возникает это «но»…
Скорость засветки у электронно-лучевого литографа на порядки меньше скорости засветки у лазерного генератора фотошаблонов.
На один фотошаблон может потребоваться до нескольких суток, а если учесть что полный комплект фотошаблонов для микросхемы может состоять из 80 шт. этих фотошаблонов, то срок производства комплекта фотошаблонов (масок) может занять несколько месяцев.
Учитывая стоимость электронно-лучевого литографа (порядка 15 млн. USD) становится понятно, почему комплект масок для техпроцесса 130 нм может стоить 500 тыс. USD, а для продвинутого техпроцесса 7-14 нм может легко уйти за 10 млн. USD.
Может, стоит ускориться?
Да, это того стоит. Поэтому естественно родилась идея повторить принцип работы лазерных генераторов изображения, использующих для засветки до миллиона одновременно управляемых лазерных лучей. Эти лучи отражаются от микро-зеркал, которые программно «дергаются» и отбрасывают лазерный луч то на пластину (через специальное микро-отверстие), то мимо (на поглотитель). Так формируется изображение на засвечиваемой пластине.
Выглядит красиво – сотни тысяч, или даже миллион электронных лучей, одновременно облучают пластину с невероятной точностью в 1-5 нм. Мы получаем технологию, при которой возможно вообще отказаться от столь дорогостоящего звена как фотошаблоны. И возможно производство прототипов, малых и средних партий микросхем по разумным ценам!
Но… Опять это «но»… «Гладко было на бумаге».
Отсюда начнем описание имеющихся вариантов технологий Электронно-много-лучевых технологий и проблем на пути их реализации.
Технология от IMS Nanofabrication (IMS-NANO) - самая «простая»
Самый скромный участник соревнований технологий электронно-много-лучевой литографии, но достигший осязаемых коммерческих результатов.
В рамках европейской программы MAGIC (MAskless lithoGraphy for IC manufacturing), были выделены 11,75 млн. евро на поддержку компаний MAPPER и IMS Nanofabrication.
Компания IMS Nanofabrication AG (Австрия) вначале развивала проект ионно-много-лучевого литографа CHARPAN (Charged Particle Nanotech).
К февралю 2009 года был создан образец доказывающий работоспособность концепции. На ионах водорода с энергией 10 кэВ при диаметре луча 12,5 нм на резисте HSQ было получено разрешение менее 16 нм. Количество лучей в матрице ~43’000 шт.
Но ионы водорода нежелательный элемент, остающийся в кремниевой подложке после засветки фоторезиста.
Поэтому, начиная с 2009 года, компания перенесла свое внимание на разработку электронно-много-лучевого литографа по проекту RIMANA (Radical Innovation Maskless Nanolithography), также при финансовой поддержке от Европейской комиссии. Причем, вначале использовались апертурная и гасящая матрица из проекта ионно-много-лучевой литографии.

Электронно-лучевая колона по проекту RIMANA позволяла использовать только 2’500 лучей из возможных 43’000. Поэтому с четвертого квартала 2009 года было начата работа над созданием новой колоны и матрицы для нее.
К 2013 году был собран электронно-лучевой литограф с матрицей на 262’144 (512х512) лучей с диаметром пятна каждого луча 20 нм.

Установка уровня доказательства концепции IMS-NANO – аппарат экспонирования фотошаблонов eMET (electron Mask Exposure Tool):
Кол-во программируемых лучей (# of programmable beams) |
262’144 шт. |
поток данных (Data path) |
12.8 Гбит/с |
энергия электронов (Beam energy) |
50 кэВ |
размер луча (Beam size) |
20 нм |
размытие (Column blur) |
5нм 1сигма |
сетка позиционирование луча (Address grid |
0.1 нм |
способ записи (Writing) |
сканирование по столу |
общий ток колоны (Current) |
0.2-1 мкА |
производительность (TPT) |
до 10 см2/час |
Компания решила увеличить размер пятна до 20 нм – это позволяет повысить производительность, увеличив ток пятна, а путем частичного смещения места засветки на неполный размер пятна и управлением времени засветки, возможно создания элементов топологии с размерами 1/3-1/2 от размера пятна.

Так при смещении пятна на половину его размера и времени засветки длительностью 33% от полного, возможно получение элемента топологии размером 10 нм. Литограф от IMS позволяет управлять смещением пятна с точностью до 0,1 нм
В IMS Nanofabrication решили не хватать звезд с небес – строить аппарат способный конкурировать с аппаратами проекционной литографии от ASML (монополиста на рынке литографии для микроэлектроники). В компании пошли по твердому пути – постройке электронно-лучевой колоны по классической схеме отработанной на электронно-лучевых микроскопах. С некритическим током электронной пушки и с небольшими токами в отдельных лучах.
Отказ от предельных токов, позволил использовать общепринятую электронно-оптическую схему с кроссоверами (местами где отдельные лучи пересекаются), и соответственно, использовать, хорошо изученные макро-линзы и макро-дефлекторы для управления и масштабирования всего пучка лучей сразу. Это значительно упростило электронно-оптическую схему и схемотехнические решения системы управления.
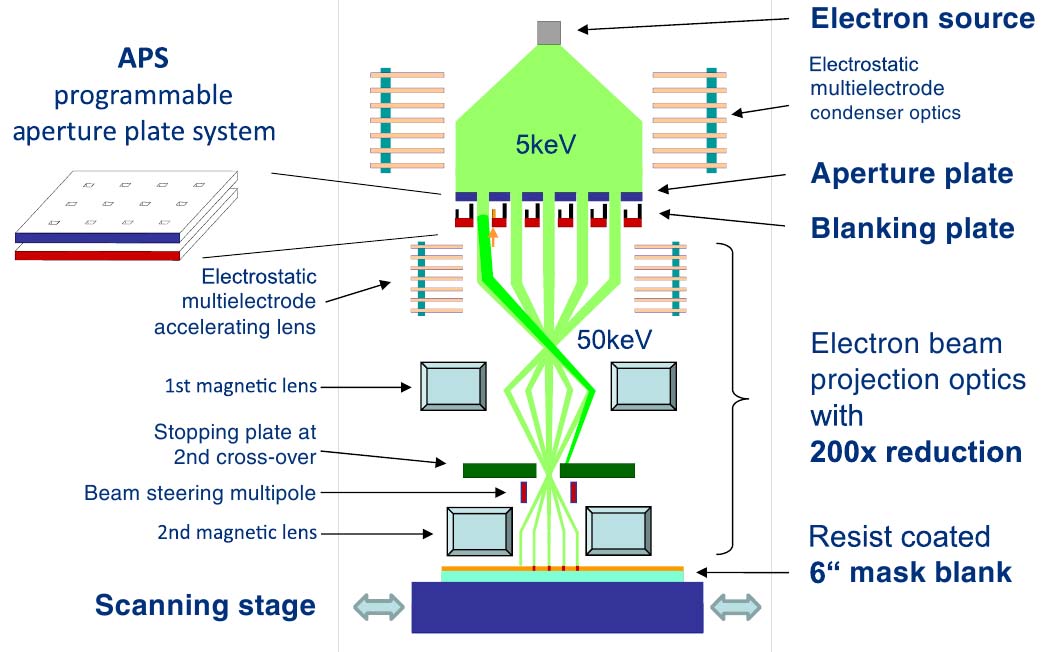
Поток электронов из электронного источника (Electron source), коллимируется электростатической конденсорной многоэлектродной оптикой (Electrostatic multielectrode condenser optic). Программируемой апертурной пластиной (APS), состоящей из апертурной пластины (Aperture plate) и гасящей пластины (Blanking plate) формируется пучок лучей. Электростатической многоэлектродной ускоряющей линзой (Electrostatic multielectrode accelerating lens) энергия электронов повышается до 50 кэВ и фокусируется в 1-й кроссовер.
1-я магнитная линза (1st magnetic lens) фокусирует пучок во 2-й кроссовер в центре апертурного отверстия останавливающей пластины (Stopping plate at 2nd cross-over). Электронный луч, который был немного отклонен гасящей пластиной (ярко-зеленый) не попадает во 2-й кроссовер, а поглощается останавливающей пластиной. С помощью многополюсной отклоняющей (дифлекторной) системы (Beam steering multipole) пучок электронов может отклоняться, тем самым засвечивая промежутки между лучами и компенсируя при необходимости движение непрерывно двигающегося сканируемого стола (Scanning stage). 2-я объектная магнитная линза (2nd magnetic lens) окончательно фокусирует пучок на пластине или фотошаблоне покрытом резистом (Resist coated 6” mask blank).
Общее масштабирование (уменьшение) создаваемое электронной оптикой составляет 200 крат (Electron beam projection optics with 200x reduction).
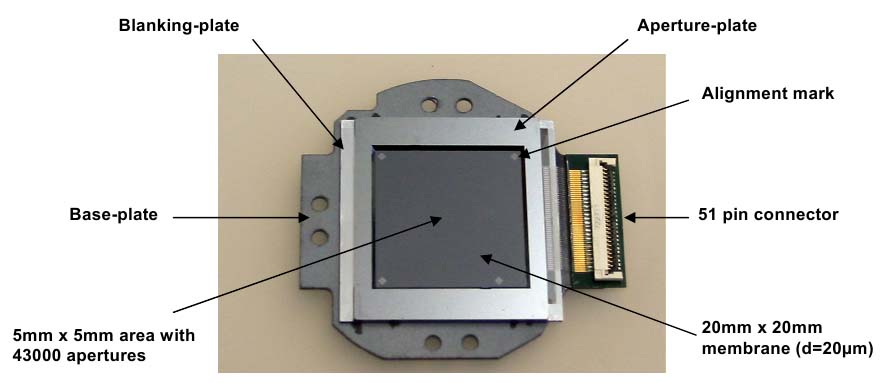
Хотя технология не обладает выдающимися показателями производительности (10 кв. см в час), относительно других технологий электронно-много-лучевой литографии, но на порядок превосходит производительность электронно-одно-лучевой литографии.
А относительная простота, позволила довести ее до коммерческого промышленного уровня для производства фотошаблонов. На текущий момент компания расширяет свое присутствие на рынках Тайваня, Южной Кореи и США.
Первые результаты экспонирования:
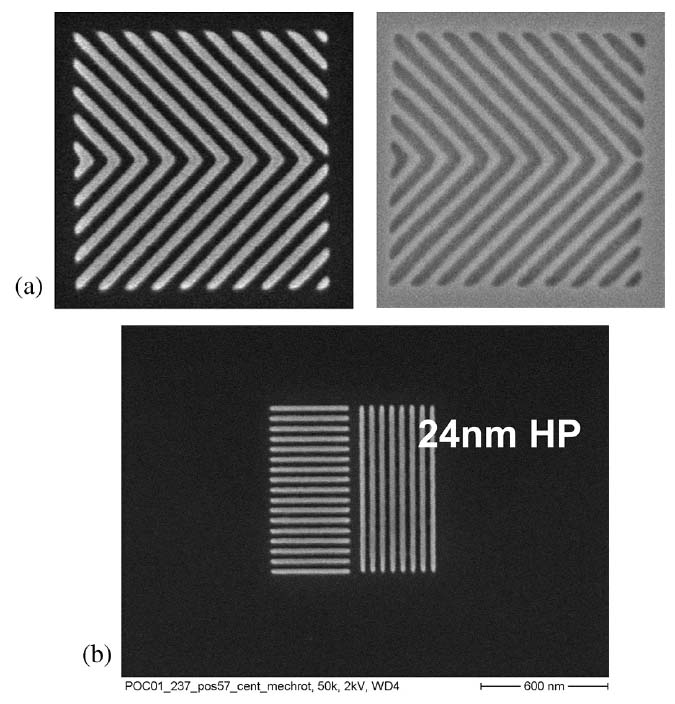

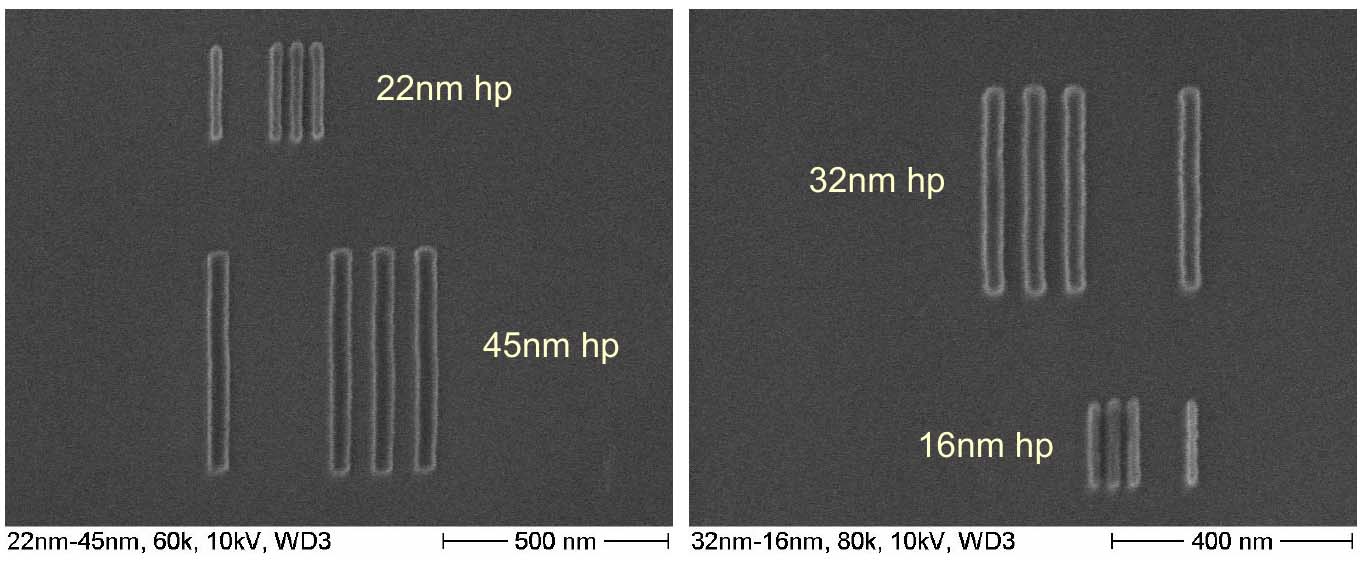
Показанные на картинках первые результаты сравнимы с лучшими показателями для EUV литографии (длина волны 13,5 нм) от ASML, но скорость засветки не позволяет конкурировать с технологией проекционной литографии для массового производства микросхем. Рынком для технологии от IMS Nanofabrication остается рынок фотошаблонов, (кстати достигший в 2021 году 4,2 млрд USD), рынок прототипов и малых партий микросхем.
Это 1-я статья из цикла.
2-я статья - Mapper — наш, или еще одна технология электронно-много-лучевой литографии
3-я статья - KLA-Tencor — революция в много-лучевой электронной литографии
Комментарии (42)

4p4
00.00.0000 00:00+2Спасибо. А почему надо делать именно матрицу, например 512х512, может проще как на сканере поставить 250000 лазеров в ряд и двигать под ними пластину сервомотором?

vazir
00.00.0000 00:00+1Повидимому на этих масштабах самый точный сервопривод это бревно когда нужна иголка

KonstantinC Автор
00.00.0000 00:00+5Вообще сервопровода применяют на степерах. Его точность определяется дискретностью токов у драйверов этого сервопривода и точностью механики. Конечно обычный драйвер и энкодер с алиэкспресс будет, как Вы сказали "бревном". Роль энкодеров выполняют гетеродинные интерферометры с точностью 0,6нм. Но для последних литографов и этого мало, так как нужна повторяемость, когда нужна последовательность из 80 засветок-травлений (на 80 фотошаблонов.)

checkpoint
00.00.0000 00:00Повидимому на этих масштабах самый точный сервопривод это бревно когда нужна иголка
Есть MEMS технологии с весьма точным позиционированием. Если не ошибаюсь, используется в сканирующих зондовых микроскопах. Но там другая проблема - малая область перемещения.

KonstantinC Автор
00.00.0000 00:00+3Да, в зондовых микроскопах, используют пьезоактуаторы. И действительно, у пьезокатуаторов диапазон перемещений измеряется мкм (с мультплексором до 2,5мм). Есть "шагающие" пьезоприводы, с диапазоном перемещений зависящим от длины штока. Но... время жизни таких приводов годиться только для периодических включений. В случае работы 24/7 они умирают в считанные месяцы.
Вообще стол для электронно-лучевого литографа - это тоже проблема. Т.к. он должен работать в вакууме (т.е. желательно без смазки), а его привод не должен создавать электро-магнитных помех. Т.к. поток электронов очень чувствителен к электромагнитному полю. Кстати на фото аппарата eMET видна "рама" - это датчик внешнего магнитного поля (Земли), для системы компенсации этого поля.
В мире координатные столы с такими параметрами делаются "под заказ"
Сейчас в России тоже стоит задача сделать стол с такими параметрами.

checkpoint
00.00.0000 00:00Сейчас в России тоже стоит задача сделать стол с такими параметрами.
Это как бы намекает... на то, что упор будет делаться на многолучевую электронную литографию ?

KonstantinC Автор
00.00.0000 00:00Есть такое

checkpoint
00.00.0000 00:00Это радует.
Расскажите какие еще есть проблемы в этой теме ?

KonstantinC Автор
00.00.0000 00:00+1Коротко, на данный момент не решенная никем проблема - это загрязнение электронно-оптической системы продуктами испарения от фоторезиста. Пока получается снизить скорость зарастания апертурных отверстий, но избавиться от этого еще не удалось никому.
Так же нет достаточно надежного источника электронов, необходима их постоянная замена.
Думаю коснуться этого в следующих публикациях

checkpoint
00.00.0000 00:00А эти пары резиста разве не поддаются оклонению в электростатическом поле ? Мне видится пара сменных пластин-конденсаторов побокам колонны и приложенное к ним постоянно напряжение, с соответствующей корректировкой потока электронов для компенисации E.

KonstantinC Автор
00.00.0000 00:00+3Пары резиста не несут заряда. Если их зарядить, то они с еще большей интенсивностью осядут на поверхности электродов электронных линз. А это тоже совсем не желательный эффект, т.к. на поверхностях электродов появиться пленка с диэлектрической проницаемостью отличной от окружающего пространства. Картина напряженности эл.поля линзы измениться непредсказуемо и наши электроны полетят совсем не туда куда надо.
Для борьбы с парами (самые вредные из них это органика) запускают радикалы кислорода, они окисляют эти пары и снижают их способность к осаждению и сращиванию.
Окисленные пары постоянно откачивают.
Но все это, как Вы понимаете есть "костыли".
Пока хорошего инженерного решения не найдено.

checkpoint
00.00.0000 00:00Пары резиста не несут заряда.
Это весьма странно. На мой обывательский взгляд на резисте должен скапливаться отрицательный заряд. Пластина которая подвергается обработке имеет какую-то электрическую связь для отвода зарядов ? Если это металлическая заготовка для маски, то предполагаю, что она же является анодом. А как обрабатывают кремниевую вафлю ?
Если их зарядить, то они с еще большей интенсивностью осядут на поверхности электродов электронных линз.
Это если их статическим полем не отводить. Но IMHO резист очень даже заряжается.

KonstantinC Автор
00.00.0000 00:00+6Это весьма странно. На мой обывательский взгляд на резисте должен скапливаться отрицательный заряд
Заряд снимается специальным контактом (кремний проводит ток). Но, Вы, вероятно, путаете пары с частицами. Пар это молекула и чтобы она несла заряд ей необходимо сообщить довольно немаленькую энергию, т.е. ионизировать. А частицы будучи довольно внушительным собранием молекул могут схватить или потерять пару электронов без большого энергетического воздействия.
Это если их статическим полем не отводить
Как раз статических полей в электронно-оптической колоне предостаточно. В частности электроды у IMS находятся под потенциалом до 50 кВ. Могут и больше, IMS не раскрывает свою систему распределения потенциалов по линзам. Но ускоряют они электроны до 50 кеВ.
Вообще лишние статические поля - это дополнительные проблемы, т.к. они изменяют энергию электронов. И если эти изменения не служат задачам оптики, то с почти 100% вероятностью они вносят в систему дополнительный разброс по энергиям, что ведет к увеличению хроматических аберраций. А это итак головная боль.
Добавлю, для объективности, Ваша идея с ионизацией паров, в принципе реализована у IMS в их источнике электронов. Они специально смещают оптическую ось электронной пушки, так, что вылетевшие из нее электроны ионизируют частицы паров, которые "осмелились" подлететь к "дулу". Получив приличный удар электроном частица ионизируется (заряжается положительно) и ускоряется в сторону этого дула, но "промахивается" т.к. оптическая ось несимметрична. Они даже навострились таким "макаром" (бомбардировкой ионами) чистить излучающую поверхность электронной пушки, в специальном режиме очистки.
Но нам пока до этих фокусов далеко.
Нам пока к столу, к столу...

KonstantinC Автор
00.00.0000 00:00Добавлю еще, что очистка пушки не решает остальную проблему загрязнения всей остальной колонны и зарастания апертурных отверстий.

checkpoint
00.00.0000 00:00Еще раз спасибо за разьяснения. Как говаривал герой известного кинофильма - "всё украдено до нас", т.е. все очевидные решения уже давно испробованы.

KonstantinC Автор
00.00.0000 00:00:) , очевидными они становятся когда их сделают.
А пока, например, решения с загрязнением системы не придумано.
Когда придумают, многие будут говорить, что это же очевидно )

checkpoint
00.00.0000 00:00Такова диалектика научного знания.
Еще один дилетантский вопрос: почему нельзя отказаться от резиста и полностью перейти на ионно-лучевое травление и молекулярно-лучевую эпитаксию по образу многолучевой электронной литографии? Понятно, что тут требуется решать совсем другие задачи, но как мне видится тут есть свои плюсы: убирается много промежуточных и очень геморойных операций с резистом (нанесение, отверждение, кислотное травление, очистка от резиста), в процессе задействовано меньше всякой сверхчистой химии (которую еще предстоит изобрести), меньше воздействий на заготовку. При этом, теоритически, заготовку до конца обработки можно не вынимать из аппарата. А это решает проблему совмещения слоёв. Как следствие, выше выход годных. Что думают ученые мужи на эту тему ?

KonstantinC Автор
00.00.0000 00:00Причина - время.
На проекционном аппарате типа ASML можно засветить резист менее чем за 30 сек на все площади пластины. Дальше травление, опять же на всей площади пластины сразу. Причем в аппарат травления можно запихнуть несколько пластин сразу. Обычно производительность фабрики зависит от производительности литографов.
Если травить лучом ионов с сечением в несколько десятком нм, то травить одну пластину придется 1000 лет (в прямом смысле), а то и больше, т.к. скорость процесса на несколько порядков ниже, чем засветка фоторезиста.

checkpoint
00.00.0000 00:00Причина - время.
Эта причина понятна. Насколько мне известно есть методы "ускорения". Например, обрабатывать заготовку сначала грубым (толстым) лучом, потом постепенно уменьшать диаметр пятна и вырисовывать мелкие детали. Догадываюсь, что это недостаточное ускорение, но почему бы не поработать в этом направлении? Какие мысли на счет многолучевого ионного травления ? Возможно ли такое ?
PS: Сверхмассовое производство пока можно оставить в сторонке.

KonstantinC Автор
00.00.0000 00:00Я не очень разбираюсь в ионном травлении.
Но есть многоговорящий факт, что IMS вначале разрабатывали ионно-многолучевую-систему (у таких систем разрешение выше чем у электронно-лучевых), построили аппарат, получили результаты лучше чем у электронно-лучевой системы у них на данный момент, но в итоге забросили эту тему.

checkpoint
00.00.0000 00:00Предполагаю, что они не нашли ей коммерческого применения, как это часто бывает, от части по причине медленности процесса. В отличии от многолучевой электронной литографии, которая востребована прежде всего для изготовления масок.
Так может быть имеет смысл подобрать то, что просто так валяется, стряхнуть пыль, доработать напильником... ;)

KonstantinC Автор
00.00.0000 00:00+2Так может быть имеет смысл подобрать то, что просто так валяется, стряхнуть пыль, доработать напильником... ;)
Мы собственно (наш startup), это и хотим сделать. От Mapper осталось отлаженное производство в Москве. Они делают одну из самых прецизионных частей в аппарате - апертурные пластины и дефлекторы (и даже электронные микро-линзы, которые не используются в технологии от IMS).
Mapper (Москва) не против предоставить для проекта свои компетенции.
Но, пока, еще стоит вопрос с финансированием.

checkpoint
00.00.0000 00:00+1Уверен у вас всё получится.
Небольшое пожелание: сделайте проект более-менее публичным, привлекайте мнения людей со стороны - идеи и решения той или иной проблемы могут появится совершенно неоткуда. Очень уж мы все устали от закрытых полу- и около-государстенных шараг, на которые выделяются страшные деньги из бюджета с полным отсутствием результата (либо с красивым результатом на бумаге и только).

KonstantinC Автор
00.00.0000 00:00+1Небольшое пожелание: сделайте проект более-менее публичным
Ну как видите, я этим уже занимаюсь

Igler_U
00.00.0000 00:00в России тоже стоит задача сделать стол с такими параметрами
Есть ли информация - идет ли процесс и привлекли ли кого для решения данной задачи? Слышал о разработках НИУ МЭИ в части прецизионных столов (вроде 5нм достигнутых).

KonstantinC Автор
00.00.0000 00:00Нужно не только, чтобы стол был прецизионным, но и чтобы он работал в вакууме (не загрязняя его), и не создавал неконтролируемых электромагнитных полей.
Насчет НИУ МЭИ не слышал.
Вообще тема литографии летает в воздухе и соответственно координатных столов для нее.
Наши бюджетные организации не страдают открытостью. Финансирование литографии получил МИЭТ. Он нанимает подрядчиков, кто в их рядах, сказать сложно.
Мы пытаемся запустить свой startup. Даже стали участником Сколково. Но стать участником и получить финансирование - это две большие разницы.

Igler_U
00.00.0000 00:00Насчет НИУ МЭИ не слышал.
Сейчас, похоже, сайт у них поломался (видимо, на фоне партнерства с HIWIN). Но информация по теме (и около) есть, если поискать.Из основного можно найти по названиям:
"Планарный стол с позиционным разрешением 5 нм"
"ИССЛЕДОВАНИЕ И РАЗРАБОТКА ПРЕЦИЗИОННОГО ПЛАНАРНОГО
ЭЛЕКТРОПРИВОДА" (диссертация)Также по подобным работам отмечалось некогда Амфора, но нужно искать-собирать остатки ее (что-то на УОМЗе, наверное, доживает, может еще где).
Еще может быть заинтересует - НПО Асферика, занимается станкостроением для прецизионной обработки (соответственно и тема точности, жесткости, датчиков, приводов близка...).
чтобы он работал в вакууме (не загрязняя его), и не создавал неконтролируемых электромагнитных полей.
в основном сверхпрецизионные платформы это некоторое сочетание аэростатических и магнитных опор. Вряд ли напрямую это можно соединить с вакуумом и отсутствием полей. Но, наверное, в целом решаемо.

KonstantinC Автор
00.00.0000 00:00Вряд ли напрямую это можно соединить с вакуумом и отсутствием полей.
Это точно.
С планарными столами вообще сложно. Они не те устройства, которые могут приехать на место и стоять. У них постоянно идет "ряб", так что 5 нм - это по факту "размытая" полоса "дрожи" в 10 нм. Эту "дрож" невозможно подавить подруливающими системами.

KonstantinC Автор
00.00.0000 00:00+1Это определяется возможностями электронно-оптической системы. Для электронно оптики желательно строить Оси-симметричную систему ("столб", а не "веер"). Растянуть пучок электронов в коллимированный поток даже с размерами как у IMS (16х16мм) - это не простая задача. А сделать хороший "веер" (с равными по току и энергиям лучами) в 256мм вообще можно сказать задачка за пределами разумного.

rPman
00.00.0000 00:00технология не обладает выдающимися показателями производительности (10 кв. см в час)
если нужно на подложке нарисовать 100500 одинаковых чипов, можно попробовать умножить количество лучей с помощью их разделения на несколько (призмы/полупрозрачные зеркала)
KonstantinC Автор
00.00.0000 00:00Это мечта всех инженеров работающий над электронно-много-лучевыми литографами

ermouth
00.00.0000 00:00Расскажите, плиз, как решаются следующие проблемы:
Электрон – заряженная частица, в отличие от фотона. Электроны в луче друг друга «расталкивают», ухудшая фокусировку, причём чем выше ток, тем сильнее эффект. Микроамперы по прикидкам – достаточный ток, чтобы сделать указанные нанометры практически недостижимыми. Как это решают?
Более общий вопрос: как борются с аберрациями в фокусирующей системе?
Электрон энергии 50кэВ обязательно породит каскад вторичных электронов в резисте, и эти вторичные электроны полетят в резисте во все стороны, и средняя длина свободного пробега будет куда больше означенных 5 нм. Это значит, луч будет засвечивать не только то место, куда он попал, но и некоторую окрестность, довольно существенную. Как это решают?
Чтобы обеспечить 1–5нм нужен очень особый резист и очень особый проявитель, чтобы за счёт локальных флуктаций концентрации проявителя из-за броуновского движения прямые линии не становились «щербатыми». Как с этим быть, с учётом что это фундаментальное ограничение.

KonstantinC Автор
00.00.0000 00:00+21. Окончательное схождение в пятно 20 нм происходит на коротком участке пути. Для IMS это менее 1 мм (фокусное расстояние проецирующей линзы). Такие сложные места в этом вопросе, как кроссовер, IMS специально размазывает вдоль оси симметрии, компенсируя размазывание разными энергиями электронов. Это довольно интересное инженерное решение. У них есть патент на это.
2. По этому поводу можно написать несколько книг. Как самое интересное решение от IMS - это специальная "дивергирующая" (дефокусирующая) линза. Специалисты по электронной оптике скажут, что такая линза невозможна. Но... IMS сделали это.
означенных 5 нм
3. У них пятно 20 нм. Расплывающееся в резисте в пятно 24-26 нм. Пятно с почти Гаусовым распределением. 50 кэВ это результат их экспериментов по минимизации расползания пятна вторичных электронов. Здесь возможно только экспериментальным путем придти к оптимальным параметрам с конкретным фоторезистом
Чтобы обеспечить 1–5нм нужен очень особый резист и очень особый проявитель
4. Луч 20 нм, засвечивает не разом пятно, а со смещением с неполной экспозицией. Получается довольно "прямоугольный" профиль засветки. "Рваность" краев порядка 2 нм, если мне не изменяет память, по их отчетам.
Так же "рваность" краев зависит от чувствительности резиста. Так на пятно 45х45нм при чувствительности фоторезиста 30мкКл/см2 надо порядка 4000 электронов, а на резист с чувствительностью 150мкКл/см2 в пять раз больше - 20000 электронов. Относительное количество электронов залетевших за край будет меньше, а значит и край ровнее.
Хвастаются результатами, обычно, на менее чувствительных резистах.
Вообще, это творческий процесс - достижение ровных краев. Это называется стратегия экспозиции. У них порядка 10-ти патентов по этому поводу. Кстати у Mapper еще больше патентов на эту тему.

ermouth
00.00.0000 00:00Спасибо.
при чувствительности фоторезиста 30мкКл/см2
Это при 50 кВ получается плотность засветки 1.5Дж/см², совершенно дикая цифра относительно фотолитографии. Похоже на PMMA, тогда и разрешение сходится – но такие резисты же страшный геморрой потом при травлении. Как с этим дела?
"Рваность" краев порядка 2 нм
на пятно 45х45нм надо порядка 4000 электроновЭто грубо 60х60 электронов, т.е. среднее расстояние примерно 1 нм. Как можно получить неровности лучше 2 нм? Оно же статистически нереалистично, там скорее неровности не менее 2 нм, разве нет?

KonstantinC Автор
00.00.0000 00:001.5Дж/см², совершенно дикая цифра
При засветке заряженными частицами (например, электронами), энергия электронов не сопоставима с энергией фотонов, при засветке чисто электромагнитной волной. Так, например, Mapper использует электроны с энергией 5кэВ, а результат в основном зависит от тока, а не от скорости электронов. Этот результат получен эмпирически. Под него пытаются смастерить теорию, кое-какая имеется, но факт в том, что при засветке электронами, как чувствительность указывают суммарный заряд, а не суммарную энергию, как в случая с фотонами.
Энергия электронов сказывается на нагреве пластины, т.е. в основном уходит в тепло, а не на хим.связи
Похоже на PMMA, тогда и разрешение сходится
PMMA возможен, но в "показательных выступлениях" используют HSQ и pCAR (посмотрите подписи под фотографиями с результатами засветок).
скорее неровности не менее 2 нм, разве нет?
Я еще раз посмотрел отчеты, где фигурировали данные по дельта CD (Critical Dimension), т.е. "рваность" краев. У IMS на HSQ получено 1,6 нм (3 сигма), pCAR 1,5 нм (3 сигма), но... чувствительность резиста при этом была 1000мкКл/см2, т.е. в нашем примере 45х45нм - это 133 тыс. электронов, т.е. примерно 8х8 электронов на нм2.
Встречный вопрос, откуда у Вас такой интерес к фоторезисту?

ermouth
00.00.0000 00:00а результат в основном зависит от тока
Но от тока же зависит и «расталкивание» в луче, выше ток – хуже фокус. В общем, я так и не понял, почему в кулонах удобнее мерять, разберусь )
откуда у Вас такой интерес к фоторезисту?
Чисто гиковский интерес к microfabrication вообще. Я чесгря с большим скепсисом относился к тиражной e-beam lithography, может, пора и пересмотреть.

KonstantinC Автор
00.00.0000 00:00Но от тока же зависит и «расталкивание» в луче, выше ток – хуже фокус
Да все верно, поэтому IMS и подняли ток лучей до некоторого компромисса между скоростью засветки и силой Кулоновского взаимодействия в луче.
В общем, я так и не понял, почему в кулонах удобнее мерять
Потому что энергия электронного луча почти не влияет на скорость засветки. Значимой величиной является кол-во электронов прилетевших в цель. Так например у Mapper электроны разгоняют до 5 кэВ, т.е. в 10 раз меньше чем у IMS, а время засветки одинаково, как у одних, так и у других, при одинаковом кол-ве электронов попавших в цель и одинаковой чувствительности резиста..

checkpoint
Спасибо, очень интересно.
Пара вопросов:
Чем обусловленно такое долгое время засветки ? Почему нельзя уменьшить время экспонирования одного "кадра", тем самым увеличив скорость сканирования ? Исходя из данных в статье время экспонирования одного кадра размером 512x512x20нмx20нм составляет примерно 60мкс. Правильно ли я понимаю, что увеличив чувствительность электрон-резиста (или энергию пучка) можно повысить скорость обработки ? Или здесь уже достигнут физический предел ?
По расчетам из данных в статье получается максмальный поток информации 4.4ГБит/сек (1/6e-5 * 512 * 512 = 520 МБайт/сек). Откуда берутся заявленные 12.8 ГБит/сек ?
KonstantinC Автор
1.По поводу чувствительности, и времени засветки. Время засветки определяется чувствительностью фоторезиста - от 5 до 200 мкКл/см2, чем чувствительнее, тем хуже контраст. При низком контрасте получаются "рваные" края. Поэтому чувствительный фоторезист годится только для "грубых" техпроцессов. Отсюда понятно, что на "тонких" техпроцессах время засветки вынужденно получается больше. Можно было бы увеличить ток, но тогда "поползет" пятно из-за Кулоновского отталкивания между электронами. От энергии электронов время засветки зависит незначительно. Энергия определят величину расползания пятна в фоторезисте. Это значительная проблема для электронно-лучевой литографии. Чем больше энергия тем электроны меньше отклоняются от первоначального направления, но больше вышибают вторичных электронов. На меньшей энергии возможна недоэкспонирование по глубине резиста. Поэтому ищут компромисс между энергией, возможной толщиной фоторезиста, временем засветки. Есть еще эффект близости, когда вполне подходящие параметры для отдельно стоящей структуры не подходят для близко стоящих структур (они начинают слипаться). Еще энергия электронов определяет нагрев пластины, и соответственно ее "расползание".
Посчитать время засветки можно исходя из тока луча (пересчитать ток на площадь пикселя). Это будет плотность тока. Далее из плотности тока получаем заряд на площадь в секунду. (для справки 1А = 1Кл/сек). Имея это параметр и зная чувствительность фоторезиста в Кл/см2 вычисляется время засветки.
2.Поле засветки у IMS представляет из себя матрицу из пикселей с 20х20нм с шагом между пикселями 160нм. (Апертурная матрица у IMS - это отверстия 4х4мкм с шагом 32мкм. После редукции 200х и получается поле засветки) После засветки пикселей происходит сдвиг для засветки промежутка между пикселями и таких здвигов укладывается 8 шт. 160нм/20нм. Но, здвиг идет не на целый пиксель, а на его часть (1/16, для "тонких" мест). Поэтому поток данных содержит больше информации чем просто Вкл/Выкл на пиксель поля.
Вообще, спасибо за вопрос. Я хотел описывать эти моменты при переходе к следующей статье, чтобы были понятны причины инженерных решений у конкурентов.